Mã QR

Các sản phẩm
Liên hệ chúng tôi

Điện thoại

Số fax
+86-579-87223657

E-mail

Địa chỉ
Đường Wangda, phố Ziyang, huyện Wuyi, thành phố Kim Hoa, tỉnh Chiết Giang, Trung Quốc
Chất nền silicon có nhiều khiếm khuyết và không thể được xử lý trực tiếp. Một màng mỏng một tinh thể cụ thể cần được phát triển trên chúng thông qua một quá trình epiticular để tạo ra các tấm wafer chip. Bộ phim mỏng này là lớp epiticular. Hầu như tất cả các thiết bị cacbua silicon được thực hiện trên các vật liệu epiticular. Các vật liệu epitaxial đồng nhất silicon chất lượng cao là cơ sở cho sự phát triển của các thiết bị cacbua silicon. Hiệu suất của các vật liệu epiticular trực tiếp xác định việc thực hiện hiệu suất của các thiết bị cacbua silicon.
Các thiết bị cacbua silicon cao và độ tin cậy cao đã đưa ra các yêu cầu nghiêm ngặt hơn về hình thái bề mặt, mật độ khiếm khuyết, pha tạp và độ dày đồng nhất của vật liệu epiticular. Kích thước lớn, mật độ độ lệch thấp và độ đồng nhất caoepitaxy cacbua siliconđã trở thành chìa khóa cho sự phát triển của ngành công nghiệp cacbua silicon.
Việc chuẩn bị chất lượng caoepitaxy cacbua siliconYêu cầu các quy trình và thiết bị nâng cao. Phương pháp tăng trưởng epiticular cacbua được sử dụng rộng rãi nhất là lắng đọng hơi hóa học (CVD), có lợi thế của việc kiểm soát chính xác độ dày màng epiticular và nồng độ pha chế, ít khuyết tật hơn, tốc độ tăng trưởng vừa phải và kiểm soát quá trình tự động. Đó là một công nghệ đáng tin cậy đã được thương mại hóa thành công.
Epitaxy cacbua silicon thường sử dụng tường nóng hoặc thiết bị CVD tường ấm, đảm bảo sự tiếp tục của lớp epiticular 4H tinh thể SIC trong điều kiện nhiệt độ tăng trưởng cao hơn (1500-1700). Sau nhiều năm phát triển, thành CVD tường nóng hoặc tường ấm có thể được chia thành các lò phản ứng cấu trúc ngang ngang và các lò phản ứng cấu trúc thẳng đứng dọc theo mối quan hệ giữa hướng của dòng khí đầu vào và bề mặt chất nền.
Chất lượng của lò epiticulace cacbua silicon chủ yếu có ba chỉ số. Đầu tiên là hiệu suất tăng trưởng epiticular, bao gồm tính đồng nhất độ dày, tính đồng nhất pha tạp, tốc độ khiếm khuyết và tốc độ tăng trưởng; Thứ hai là hiệu suất nhiệt độ của chính thiết bị, bao gồm tốc độ sưởi ấm/làm mát, nhiệt độ tối đa, độ đồng đều nhiệt độ; Và cuối cùng là hiệu suất chi phí của chính thiết bị, bao gồm giá đơn vị và năng lực sản xuất.
CVD ngang tường nóng, CVD hành tinh tường ấm áp và CVD thẳng đứng trên tường nóng là các giải pháp công nghệ thiết bị epiticular chính thống đã được áp dụng thương mại ở giai đoạn này. Ba thiết bị kỹ thuật cũng có đặc điểm riêng và có thể được chọn theo nhu cầu. Sơ đồ cấu trúc được hiển thị trong hình dưới đây:

Hệ thống CVD ngang tường nóng nói chung là một hệ thống tăng trưởng kích thước lớn đơn hơn được điều khiển bởi tuyển nổi và xoay không khí. Thật dễ dàng để đạt được các chỉ số trong wafer tốt. Mô hình đại diện là PE1O6 của Công ty LPE ở Ý. Máy này có thể nhận ra tự động tải và dỡ các tấm wafer ở 900. Các tính năng chính là tốc độ tăng trưởng cao, chu kỳ epiticular ngắn, tính nhất quán tốt trong wafer và giữa các lò, v.v ... Nó có thị phần cao nhất ở Trung Quốc.

Theo các báo cáo chính thức của LPE, kết hợp với việc sử dụng người dùng chính, các sản phẩm wafer epiticular 4-150-150mm (4-6 inch) với độ dày dưới 30μm được sản xuất bởi lò nung không đồng nhất. Mật độ ≤1cm-2, diện tích không có bề mặt (tế bào đơn vị 2 mm × 2 mm) ≥90%.
Các công ty trong nước như JSG, CETC 48, Naura và Naso đã phát triển các thiết bị epitaxial silicon cacbua nguyên khối với các chức năng tương tự và đã đạt được các lô hàng quy mô lớn. Ví dụ, vào tháng 2 năm 2023, JSG đã phát hành một thiết bị epitaxial sic gấp đôi 6 inch. Thiết bị sử dụng các lớp trên và dưới của các lớp trên và dưới của các phần than chì của buồng phản ứng để phát triển hai tấm tấm epiticular trong một lò, và các khí trên và dưới có thể được điều chỉnh riêngSic lớp phủ nửa bộ phậnChúng tôi đang cung cấp các bộ phận Half -moon 6 inch và 8 inch cho người dùng.

Hệ thống CVD hành tinh tường ấm áp, với sự sắp xếp hành tinh của cơ sở, được đặc trưng bởi sự phát triển của nhiều tấm vải trong một lò đơn và hiệu suất đầu ra cao. Các mô hình đại diện là AIXG5WWC (8x150mm) và G10-SIC (9 × 150mm hoặc 6 × 200mm) Thiết bị epiticular của Aixtron của Đức.
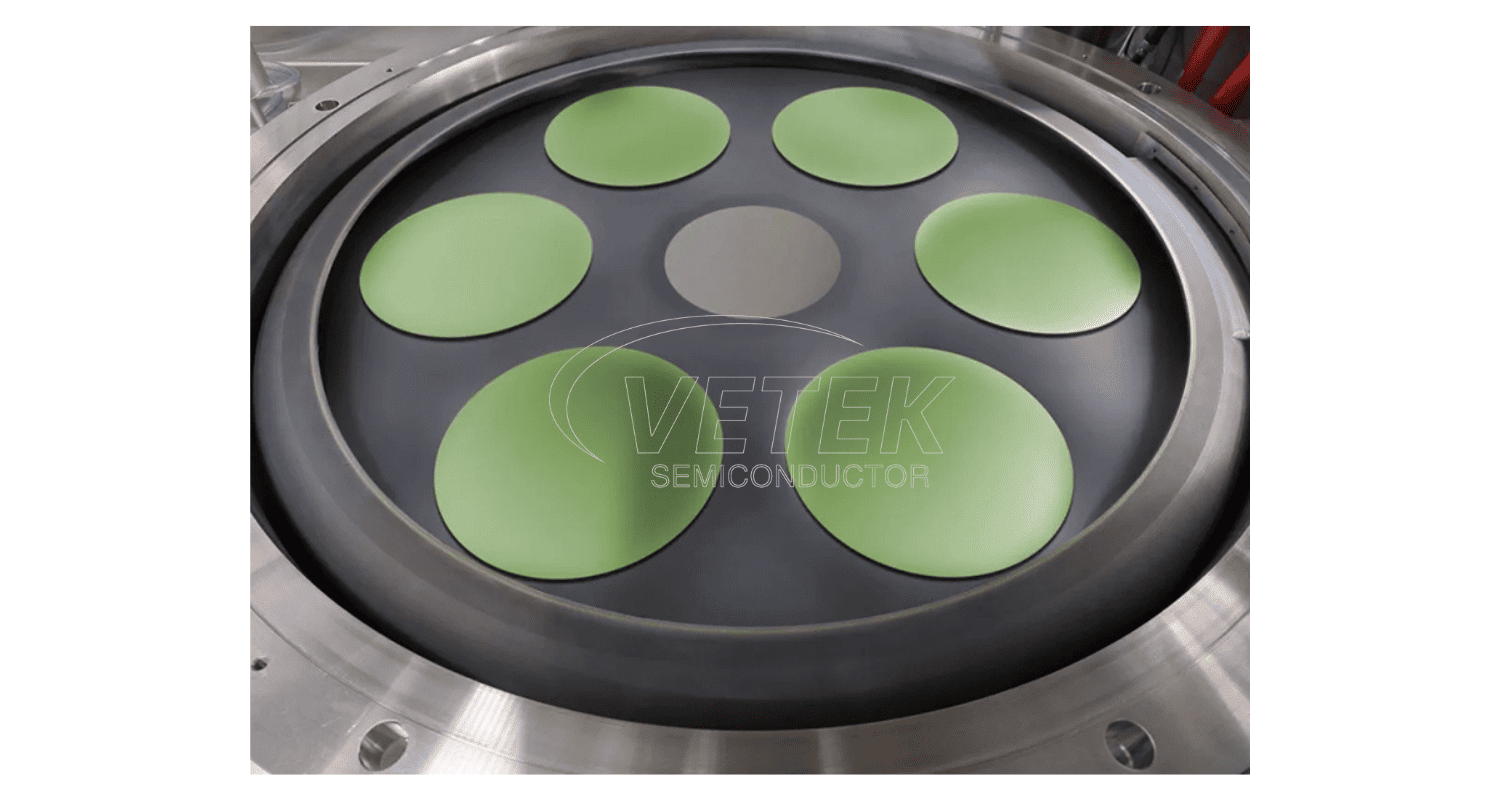
Theo báo cáo chính thức của Aixtron, các sản phẩm wafer epiticular 4H-SIC 6 inch với độ dày 10μm do lò nung của G10 có thể đạt được ổn định các chỉ số sau: Độ dày của phương pháp mô tả không gian của độ dày. Nồng độ không đồng nhất <2%.
Cho đến nay, loại mô hình này hiếm khi được người dùng trong nước sử dụng và dữ liệu sản xuất hàng loạt là không đủ, ở một mức độ nhất định hạn chế ứng dụng kỹ thuật của nó. Ngoài ra, do các rào cản kỹ thuật cao của các lò nung epiticular đa wafer về mặt trường nhiệt độ và kiểm soát trường dòng chảy, sự phát triển của các thiết bị trong nước tương tự vẫn đang trong giai đoạn nghiên cứu và phát triển, và không có mô hình thay thế nào.
Hệ thống CVD thẳng đứng quasi nóng chủ yếu quay ở tốc độ cao thông qua hỗ trợ cơ học bên ngoài. Đặc điểm của nó là độ dày của lớp nhớt được giảm hiệu quả bởi áp suất buồng phản ứng thấp hơn, do đó làm tăng tốc độ tăng trưởng epiticular. Đồng thời, buồng phản ứng của nó không có thành trên mà các hạt sic có thể được lắng đọng, và không dễ để tạo ra các vật rơi. Nó có một lợi thế cố hữu trong kiểm soát khiếm khuyết. Các mô hình đại diện là các lò nung epiticular đơn hơn epirevos6 và epirevos8 của nuflare của Nhật Bản.
Theo NUFLARE, tốc độ tăng trưởng của thiết bị epirevos6 có thể đạt hơn 50μm/h và mật độ khiếm khuyết bề mặt của wafer epiticular có thể được kiểm soát dưới 0,1cm-²; Về mặt kiểm soát tính đồng nhất, Kỹ sư Nuflare Yoshiaki Daigo đã báo cáo kết quả đồng nhất của nội bộ của Wafer 6 inch dày 10 inch bằng cách sử dụng Epirevos6, và độ dày của nội dung.Xi lanh than chì trên.
Hiện tại, các nhà sản xuất thiết bị trong nước như Core Third Penteration và JSG đã thiết kế và ra mắt thiết bị epitaxial với các chức năng tương tự, nhưng chúng không được sử dụng trên quy mô lớn.
Nhìn chung, ba loại thiết bị có đặc điểm riêng và chiếm một phần thị phần nhất định trong các nhu cầu ứng dụng khác nhau:
Cấu trúc CVD ngang tường nóng có tốc độ tăng trưởng cực nhanh, chất lượng và tính đồng nhất, vận hành và bảo trì thiết bị đơn giản, và các ứng dụng sản xuất quy mô lớn trưởng thành. Tuy nhiên, do loại wafer đơn và bảo trì thường xuyên, hiệu quả sản xuất thấp; CVD hành tinh tường ấm thường áp dụng một cấu trúc khay 6 (mảnh) × 100 mm (4 inch) hoặc 8 (mảnh) × 150 mm (6 inch), giúp cải thiện đáng kể hiệu quả sản xuất của thiết bị về khả năng sản xuất, nhưng rất khó để kiểm soát tính nhất quán của nhiều sản phẩm sản xuất vẫn là vấn đề lớn nhất; CVD thẳng đứng trên tường nóng có cấu trúc phức tạp và kiểm soát khiếm khuyết chất lượng của sản xuất wafer epiticular là tuyệt vời, đòi hỏi phải bảo trì và sử dụng thiết bị cực kỳ phong phú.
Tốc độ tăng trưởng nhanh
đơn giản Cấu trúc thiết bị và
Bảo trì thuận tiện
Năng lực sản xuất lớn
Hiệu quả sản xuất cao
Kiểm soát khiếm khuyết sản phẩm tốt
buồng phản ứng dài
chu kỳ bảo trì
Cấu trúc phức tạp
khó kiểm soát
tính nhất quán của sản phẩm
Cấu trúc thiết bị phức tạp,
Bảo trì khó khăn
Tiêu biểu
thiết bị
nhà sản xuất
Tường nóng ngang CVD
CWD hành tinh tường ấm áp
CTD thẳng đứng trên tường nóng
Thuận lợi
Bất lợi
Chu kỳ bảo trì ngắn
Ý LPE, Nhật Bản Tel
Đức Aixtron
Nhật Bản Nuflare
Với sự phát triển liên tục của ngành công nghiệp, ba loại thiết bị này sẽ được tối ưu hóa và nâng cấp một cách lặp đi lặp lại về mặt cấu trúc và cấu hình thiết bị sẽ ngày càng trở nên hoàn hảo hơn, đóng vai trò quan trọng trong việc phù hợp với thông số kỹ thuật của các wafer epiticular với các yêu cầu độ dày và khiếm khuyết khác nhau.



+86-579-87223657


Đường Wangda, phố Ziyang, huyện Wuyi, thành phố Kim Hoa, tỉnh Chiết Giang, Trung Quốc
Bản quyền © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Mọi quyền được bảo lưu.
Links | Sitemap | RSS | XML | Chính sách bảo mật |
